
静态测试仪是一种用来评测各种工作条件下的半导体芯片或者模块相应电性参数的机台,可对封装和晶圆上器件进行电参数测量(Rdson、BV、LKG、Vth、Vsat、Vlin、CV 等)。在失效分析中主要用于失效样品电参数的确认。

OM (光学显微镜)是一种利用透镜或者透镜组合原理将样品放大成像的装置。利用显微镜直接观察或者配合其他样品处理手段观察失效样品是失效分析的常用手段。

X-ray microscope(X射线显微镜),是一种缺陷表征技术,用来检测器件及模组内部组装异常探测,一般用来检测芯片打线是否脱焊、短路以及芯片及模组内部空洞检测和空洞率计算
原理:利用不同物质对X-ray的吸收能力不同的特点,从而对物品进行成像。

SAM (超声波显微镜),是一种缺陷表征技术,用来检测封装器件不同材料之间分层及同一介质内部裂纹的情况。
原理:材料内部组织因密度不同而对超声波声阻抗、超声波吸收与反射程度产生差异的特点,从而实现对材料内部缺陷的定性分析,在半导体封装及材料等行业中得到广泛应用。

扫描电子显微镜(SEM)是一种介于透射电子显微镜和光学显微镜之间的一种观察手段。其利用聚焦的很窄的高能电子束来扫描样品,通过光束与物质间的相互作用,来激发各种物理信息,对这些信息收集、放大、再成像以达到对物质微观形貌表征的目的。在失效分析中主要应用于失效样品的表面微观形貌检查。
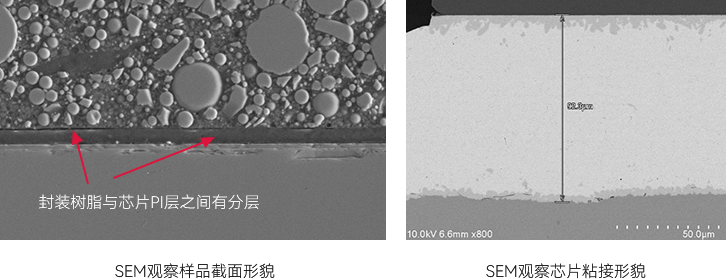
聚焦离子束扫描电子显微镜 (FIB-SEM) 是集成样品处理和样品表征于一体的机台。其具有两种束流,SEM和FIB。SEM为电子束,用于观察样品形貌;FIB为聚焦离子束,它是利用电子透镜得到的光斑很小的高能离子束,利用其与样品表面反应,可以实现样品定点切割,定点沉积等功能。FIB-SEM是强大的半导体失效分析表征工具。
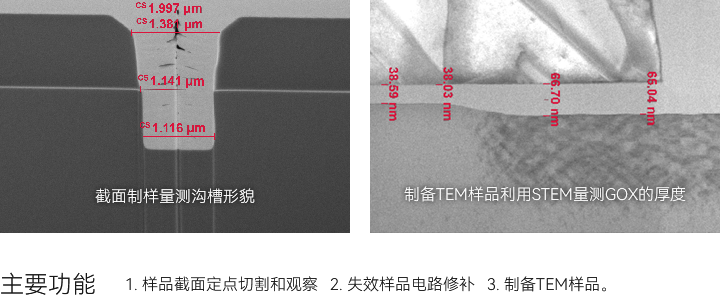
金相磨抛机 (Laser Decap) 可通过研磨和抛光的方法对样品进行表面去层或截面处理,配合OM和SEM等机台可实现样品的逐层观察和截面观察。
样品切割机(Cutter)主要针对模块样品进行定点切割,方便样品后续研磨和抛光。
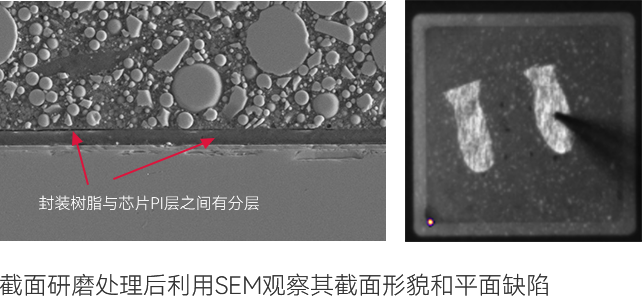
激光开封 (Laser Decap) 是通过激光将芯片或者电子元器件的塑料外壳去掉,减少化学开封对铜引线造成的腐蚀损伤。利用激光开封和化学品处理样品表面的塑封料是失效分析的常用方法。
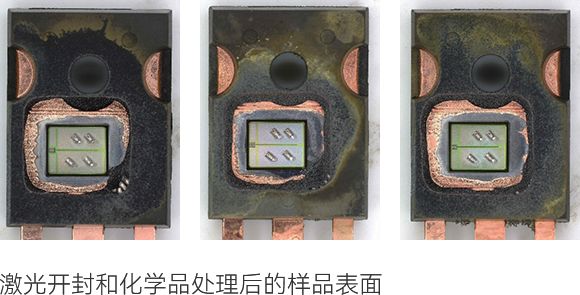
离子研磨 (CP) 利用氩离子束对样品进行抛光,可以获得表面/截面平滑的样品,而不会对样品造成机械损害。离子研磨可以去除金相研磨损伤层,从而得到高质量样品,用于在SEM,OM或者扫描探针显微镜上进行成像、EDS、EBSD、EBIC或其它分析。
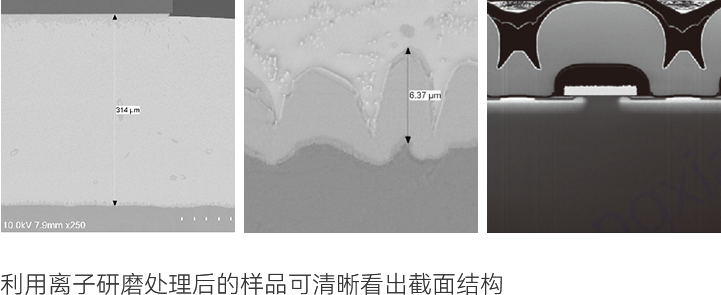
红外电性热点定位(R-thermal): 利用高灵敏度的InSb detector 侦测芯片在通电状态下,缺陷位置产生的热辐射分布,从而定位出失效所在位置。

InGaAs EMMI: 芯片在通电的状态下,MOS器件发生介质击穿、热载流子注入、PN结反向漏电以及CMOS电路发生闩锁效应时,电子空穴对复合 (EHP-Electron Hole Pairs Recombination) 并放出光子,EMMI技术通过InGaAs镜头收集发出的光子信号,将发光图和器件表面的光学发射像叠加,对失效点和缺陷进行定位。

是通过激光扫描局部加热样品,在施加直流电压的情况下,芯片中不同部位因温度变化而产生阻值变化,电流也产生变化,系统记录电流变化量,并通过不同颜色影像记录下来,借助于侦测电流变化定出芯片的失效位置。